薄膜炼金术:从原子到芯片的微观革命(二)
一、化学气相沉积概述
化学气相沉积(Chemical Vapour Deposition,CVD)是指单独地或综合的利用热能、等离子体、紫外光照射、激光照射等其它形式的能源,使气态物质在固体的热表面上发生化学反应,形成稳定的固态物质,并沉积在晶圆片表面上的一种薄膜制备技术。
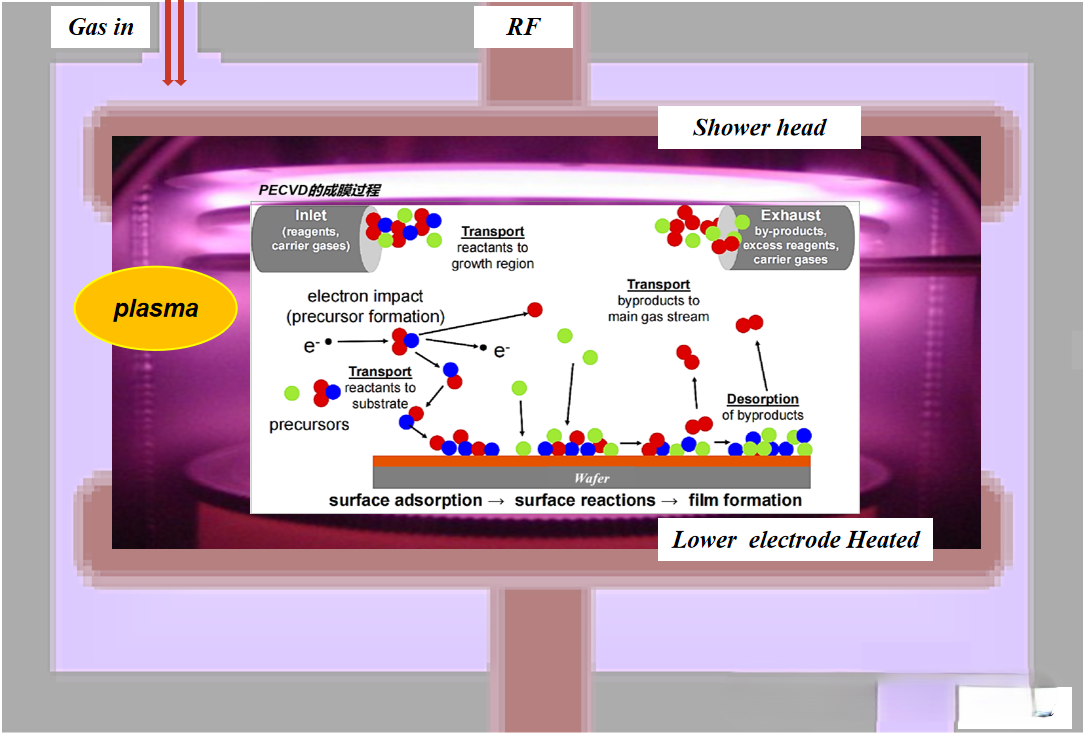
用CVD法沉积薄膜,其生长过程可分为下列步骤:
①参加反应的气体混合物被输送到衬底表面;
②反应物分子由主气流扩散到衬底表面;
③反应物分子吸附在衬底表面上;
④吸附分子与气体分子之间发生化学反应,生成硅原子和化学反应副产物,硅原子沿衬底表面迁移并结合进入晶体点阵中;
⑤反应副产物分子从衬底表面解析;
⑥副产物分子由衬底表面扩散到主气体流中,然后被排出沉积区。
化学气相沉积反应必须满足三个挥发性标准:
(1) 在沉积温度下,反应剂必须具备足够高的蒸汽压,使反应剂以合理的速度引入反应室。如果反应剂在室温下都是气体,则反应装置可以简化;如果在室温下挥发性很低,则需要用携带气体将反应剂引入反应室,在这种情况下,接反应器的气体管路需要加热,以免反应剂凝聚。
(2) 除沉积物质外,反应产物必须是挥发性的。
(3) 沉积物本身必须具有足够低的蒸汽压,使反应过程中的沉积物留在加热基片上。
二、化学气相沉积的主要反应类型
用于CVD技术的化学反应有六大类:热解反应、氢还原反应、复合还原反应、氧化反应和水解反应、金属还原反应、生成氮化物和碳化物的反应。
1. 热分解反应
原理:
单一气态前驱体在高温下直接分解,生成固态产物与挥发性副产物。
典型反应:

应用:
沉积单质(如非晶硅薄膜)或简单化合物(如 SiO₂,由 Si (OC₂H₅)₄热解),设备简单(单温区炉),适合高纯薄膜制备(如太阳能电池硅膜),但限于热稳定性前驱体。
2.氢还原反应
原理:
以 H₂为还原剂,还原金属卤化物(如氯化物、氟化物)生成固态金属 / 半导体。
典型反应:

应用:
制备高纯度半导体单质(如集成电路用多晶硅)、难熔金属(W、Mo)。需高温(>800℃),H₂易燃易爆,适用于耐高温衬底(如硅片),广泛用于芯片制造中的硅外延生长。
4. 氧化反应与水解反应
氧化反应:前驱体与O2反应生成氧化物

水解反应:前驱体与 H₂O 反应(气相或液态水)。

应用:制备绝缘氧化物薄膜(如 SiO₂栅氧化层、Al₂O₃钝化层)。氧化反应依赖高纯 O₂,水解反应需控制水汽分压,广泛用于半导体层间绝缘及 MEMS 器件封装。
5. 金属还原反应
原理:
用活泼金属(如 Zn、Mg)还原金属卤化物,低温下沉积目标金属。
典型反应:

应用:
制备难熔金属(Ti、Nb)或稀有金属薄膜,适合塑料、陶瓷等不耐高温衬底。但副产物金属盐需及时清除,避免污染,常用于微电子器件的扩散阻挡层。
6. 生成氮化物和碳化物的反应
氮化物:前驱体与 NH₃、N₂反应(热解或还原)。

碳化物前驱体与 CH₄、C₂H₂反应(热解或化合)。

应用:氮化物(如 Si₃N₄抗腐蚀钝化层、GaN 功率器件)、碳化物(SiC 耐高温涂层、耐磨薄膜)。需高温或等离子体辅助(如 PECVD 降低温度),满足高硬度、高导热性需求。
三、化学气相沉积反应的激活能
化学气相沉积反应所需要的激活能通常来源于:热能、等离子体、激光。
1. 热能激活方式
热能激活方式的化学气相沉积需要一定的热能,即反应环境需达到一定温度,通常所需的温度与反应气体压力有关,压力越小,所需的温度越高。化学气相沉积根据反应气体压力可分为常压化学气相沉积(简称APCVD)和低压化学气相沉积(简称LPCVD)。
① 常压化学气相沉积-APCVD
常压化学气相沉积是半导体制造工业中早期用来沉积氧化层和硅外延层的,现在仍然使用。常压化学气相沉积是指在大气压下进行的一种化学气相沉积的方法,反应温度介于300~500℃。这种工艺所需的系统简单,反应速度快,并且沉积速率可超过10000Å/min,特别适于介质积,但它的缺点是均匀性较差,气体消耗量大,且台阶覆盖能力差,所以常压化学气相沉积一般用在厚的介质沉积。
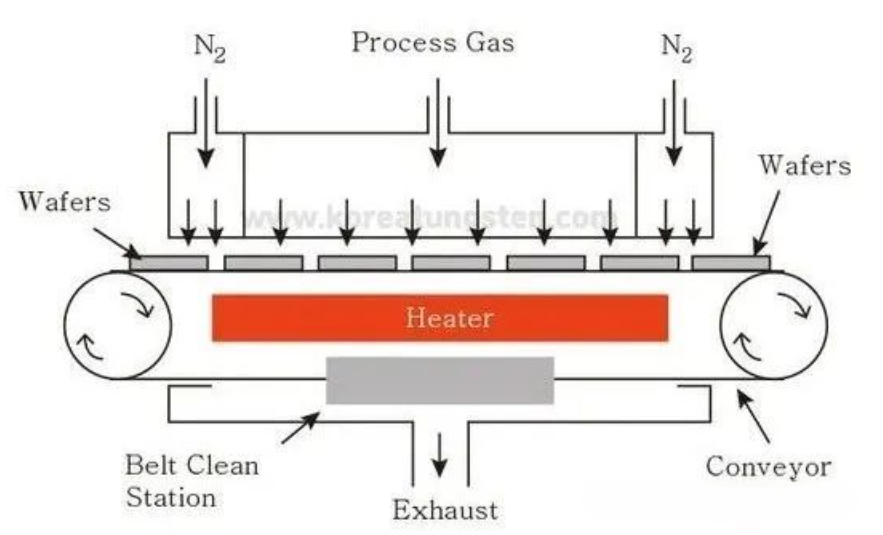
随着半导体工艺特征尺寸的减小,对薄膜的均匀性要求及膜厚误差要求的不断提高,出现了低压化学气相沉积。低压化学气相沉积就是将反应室内的压强降至0.2~2 Torr,反应温度介于500~900℃。相对常压化学气相沉积来讲,低压化学气相沉积薄膜厚度均匀性好、台阶覆盖性好、沉积速率快、生产效率高、沉积的薄膜性能更好,因此应用更广泛。低压化学气相沉积经常用于多晶硅、氮化硅膜、氧化铝以及某些金属膜的沉积。
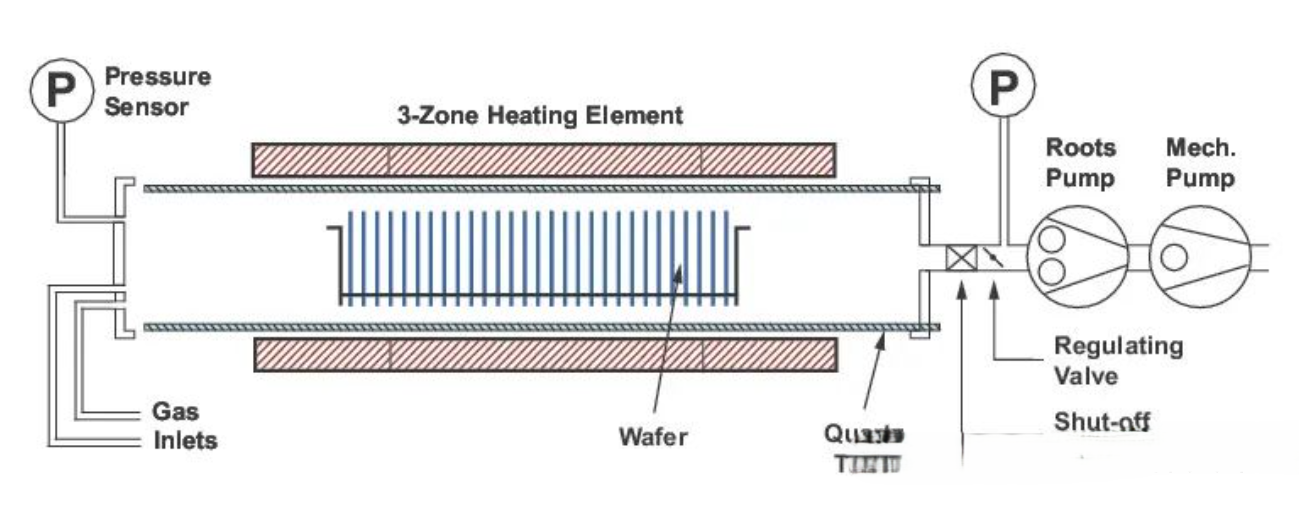
2. 等离子体激活方式
采用等离子体作为激活方式的化学气相沉积称为等离子体增强化学气相沉积(PECVD)。等离子体增强化学气相沉积是指在低真空条件下,利用直流电压(DC)、交流电压(AC)、射频(RF)、微波(MW)或电子回旋共振(ECR)等方法实现气体辉光放电,在沉积反应器中产生等离子体。由于等离子体中正离子、电子在电场的作用下能量提高,加速运动,这些带电粒子与中性反应气体分子不断碰撞,使反应气体电离或被激活成为活泼的活性基团,很容易成膜,可以大大降低沉积温度。
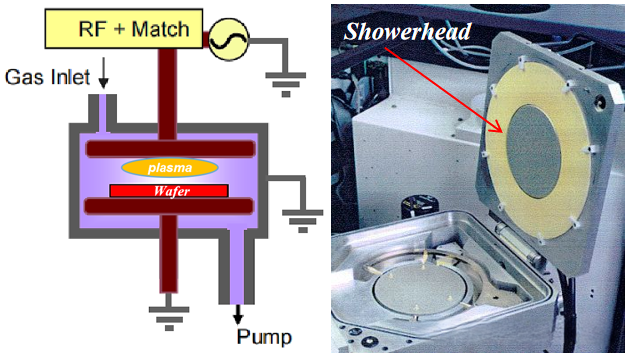
3. 激光激活方式
采用激光作为激活方式的化学气相沉积称为激光增强化学气相沉积。随着高新技术的发展,采用激光增强化学气相沉积也是常用的一种方法。
四、几种薄膜的CVD制备
1、SiO2薄膜
将含硅的化合物进行热分解,在晶圆表面沉积一层二氧化硅膜,这种工艺中,硅不参加反应,只起到衬底的作用,而且氧化温度很低,又称为“低温沉积”工艺。含硅的化合物有两种:烷氧基硅烷和硅烷。
① 烷氧基硅烷分解法
烷氧基硅烷分解法是一种含有硅与氧的有机硅化物,通常使用四乙氧基硅烷,本身在室温下为液体,使用时要加热(40~70OC)以提高其饱和蒸气压,分解成为SiO2层。
② 硅烷分解法
硅烷分解法是将硅烷在氧气气氛中加热,反应生成二氧化硅,沉积在晶圆上,这种方法生成的氧化膜质量较好,生长温度也较低。
2、Si3N4薄膜
Si3N4是一种在半导体器件及集成电路制作工艺中常见的薄膜,主要用作SiO2的刻蚀掩膜。由于Si3N4不易被氧所渗透,这层掩膜还可以在进行场氧化层制作时,作为防止晶片表面的活动区域被氧化的保护层。除了这种应用外,因为Si3N4对于碱金属离子的防堵能力也很好,且不易被水气分子所渗透,实验广泛地用作半导体器件集成电路的保护层。制作Si3N4采用LPCVD和PECVD均可。

3、多晶硅薄膜
利用多晶硅替代金属铝作为MOS器件的栅极是MOS集成电路技术的重大突破之一,它比利用金属铝作为栅极的MOS器件性能得到很大提高,而且采用多晶硅栅技术可以实现源漏区自对准离子注入,使MOS集成电路的集成度得到很大提高。多晶硅是在低压反应炉中(600~650OC)用硅烷热分解而得到的。

安徽博芯微半导体科技有限公司,为核心组件提供高精度Showerhead服务,产品主要包括Shower head、Face plate、Blocker Plate、Top Plate、Shield、Liner、pumping ring、Edge Ring等半导体设备核心零部件,产品广泛应用于半导体、显示面板等领域,性能卓越,市场认可度高。